【
儀表網 研發快訊】分焦平面陣列因具備高集成度、高魯棒性和高動態適應性等優勢,在偏振成像領域受到廣泛關注。制造分焦平面陣列的關鍵在于制備陣列化的各向異性亞波長光柵。近日,清華大學深圳國際研究生院李星輝副教授團隊在分焦面超像素陣列光刻制造領域取得新進展,為中紅外偏振成像系統的關鍵器件制備提供了新方案。
圖1.接觸-干涉混合光刻加工流程
圖2.本研究提出的混合光刻加工系統
針對中紅外偏振成像場景,研究團隊提出單循環接觸-干涉混合光刻技術。該技術采用不包含光柵精細條紋結構的窗口掩膜,對干涉光刻產生的條紋進行分區裁剪,通過四步曝光法,在20mm×20mm的區域曝光出34μm×34μm超像素陣列的潛像條紋,其中每個陣列包含四個不同方向的800nm周期光柵,并通過單循環的顯影、刻蝕、鍍膜等工藝,實現圖形轉移。
圖3.分焦平面光柵陣列結構表征
研究團隊使用有限差分時域,分析模擬了間隙大小及間隙填充介質對干涉條紋的作用,選用折射率匹配材料對間隙進行填充,抑制掩膜與基底間隙造成的干涉條紋質量下降。同時,團隊構建了基于顯微成像技術的亞微米級精度對準觀察平臺,使用掩膜板上的雙區域周期性條紋標記,實現掩膜與基底頂點的對準,成功實現了分步光刻套刻對準,避免了不同線柵區域的串擾。
研究團隊對加工樣品進行了系統的表面形貌表征與光學性能測試,掃描
電子顯微鏡(SEM)表征結果顯示,所加工面積內表現出良好的條紋質量和套刻對準精度;基于傅里葉
紅外光譜儀的光學透過性能和偏振消光比表明,在3μm-15μm的中紅外波段內該超像素陣列的子像素對TM光的最大透過率達到了50%,偏振消光比達到20dB。研究提出的混合光刻技術在加工諸如分焦平面亞波長陣列等中等復雜度多周期結構方面具有顯著優勢。
研究成果以“用于可擴展制造陣列象限微偏振器結構的單循環接觸干涉混合光刻技術”(Single-cycle contact-interference hybrid lithography for scalable fabrication of arrayed quadrant micro-polarizer structures)為題,于2025年12月15日發表于《極端制造》(International Journal of Extreme Manufacturing)。
清華大學深圳國際研究生院2021級博士生陸天石、2021級碩士生鄧富元為論文共同第一作者,李星輝為論文通訊作者。論文其他作者還包括清華大學深圳國際研究生院2023級碩士生魏雨楓、2022級碩士生曾郅鵬。研究得到國家自然科學基金與深圳市高等院校穩定支持計劃等的資助。
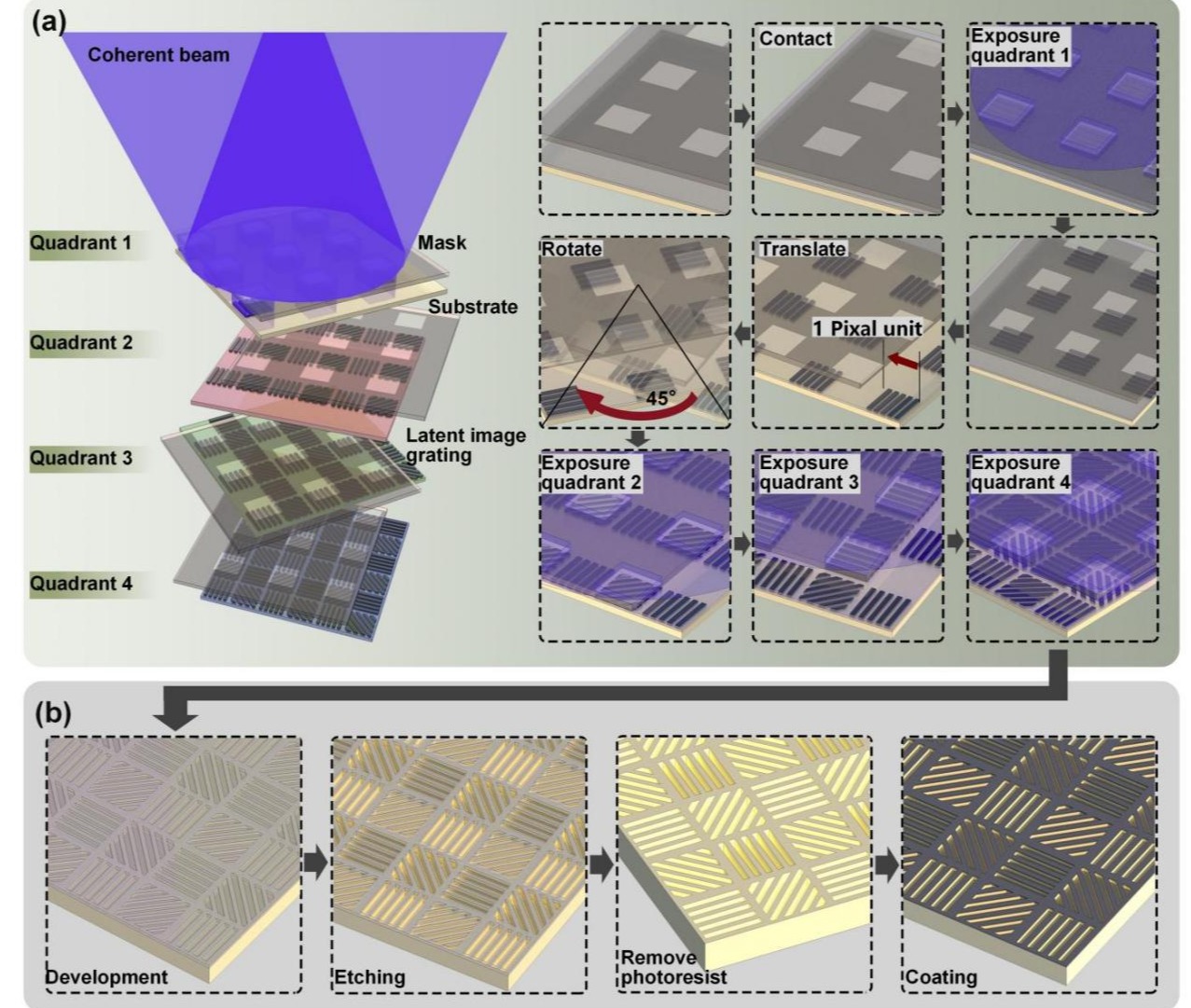
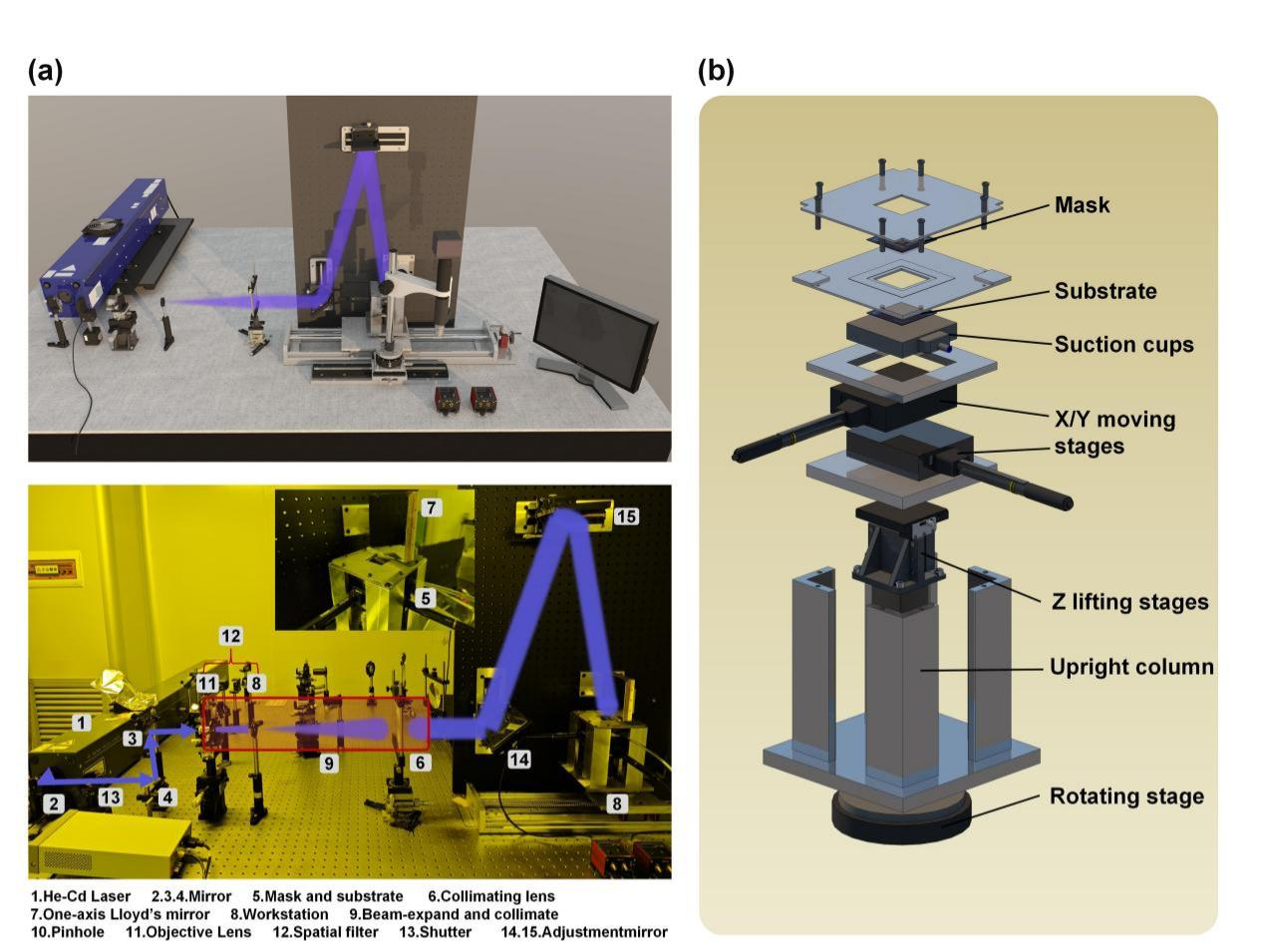
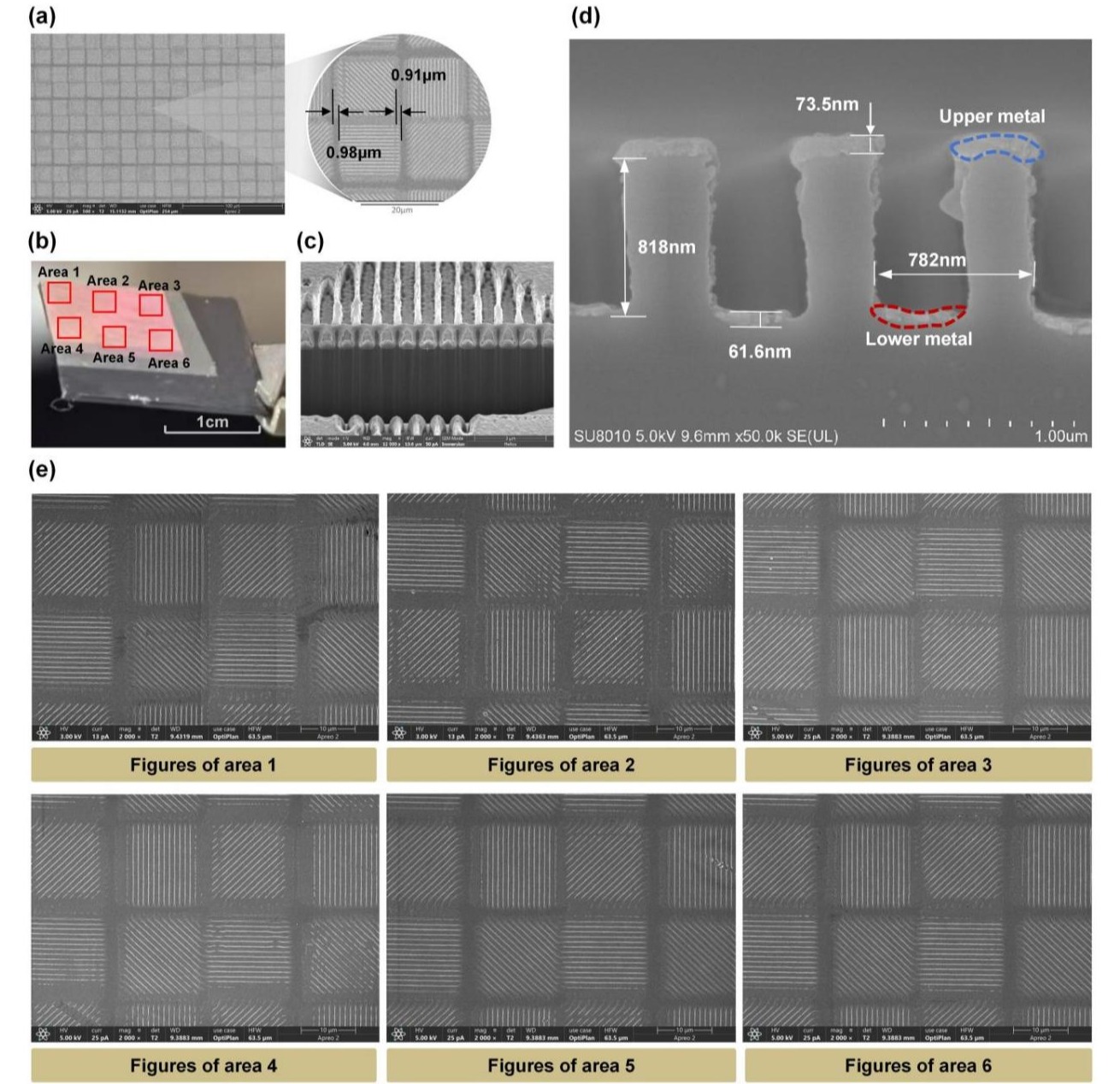
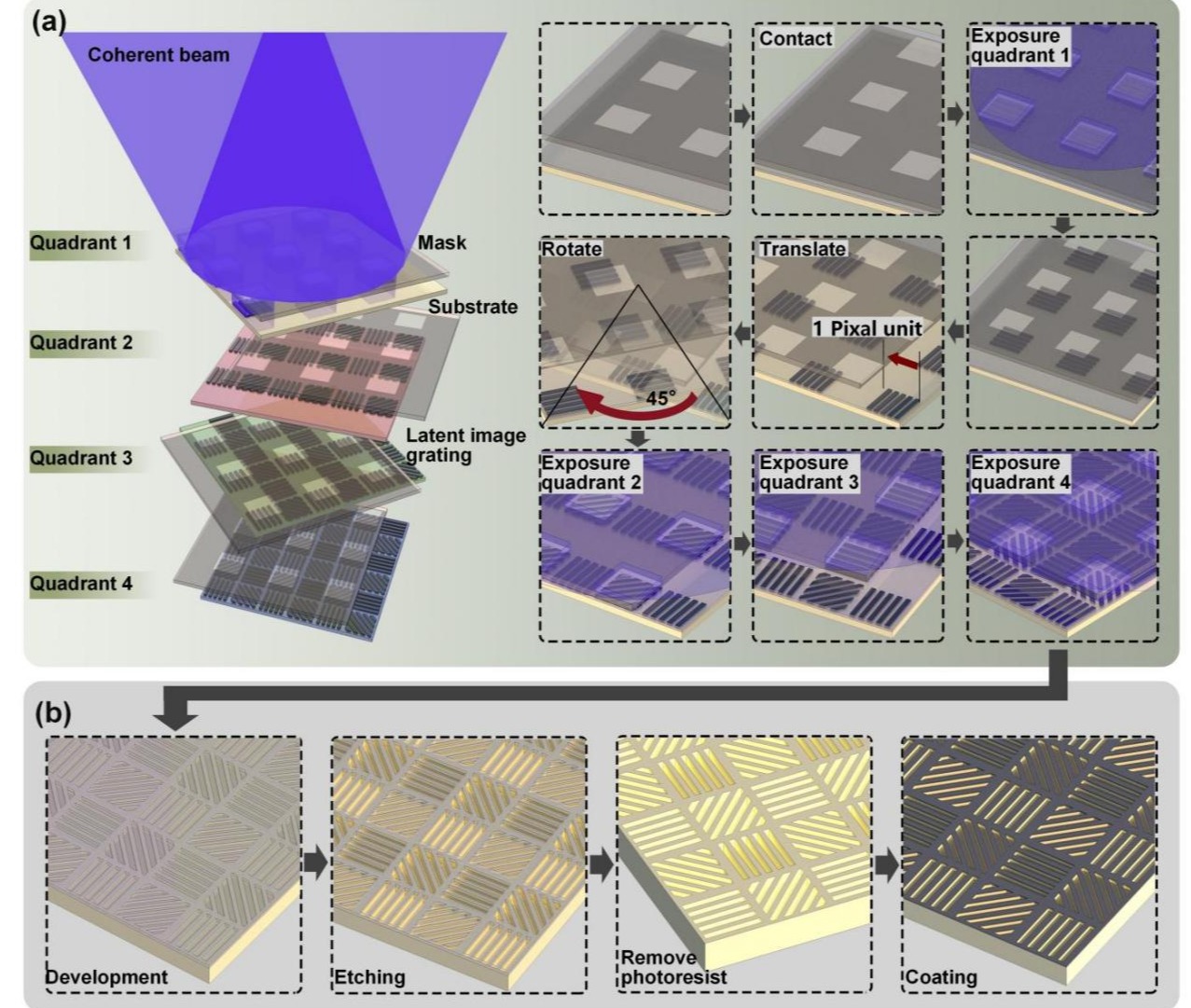
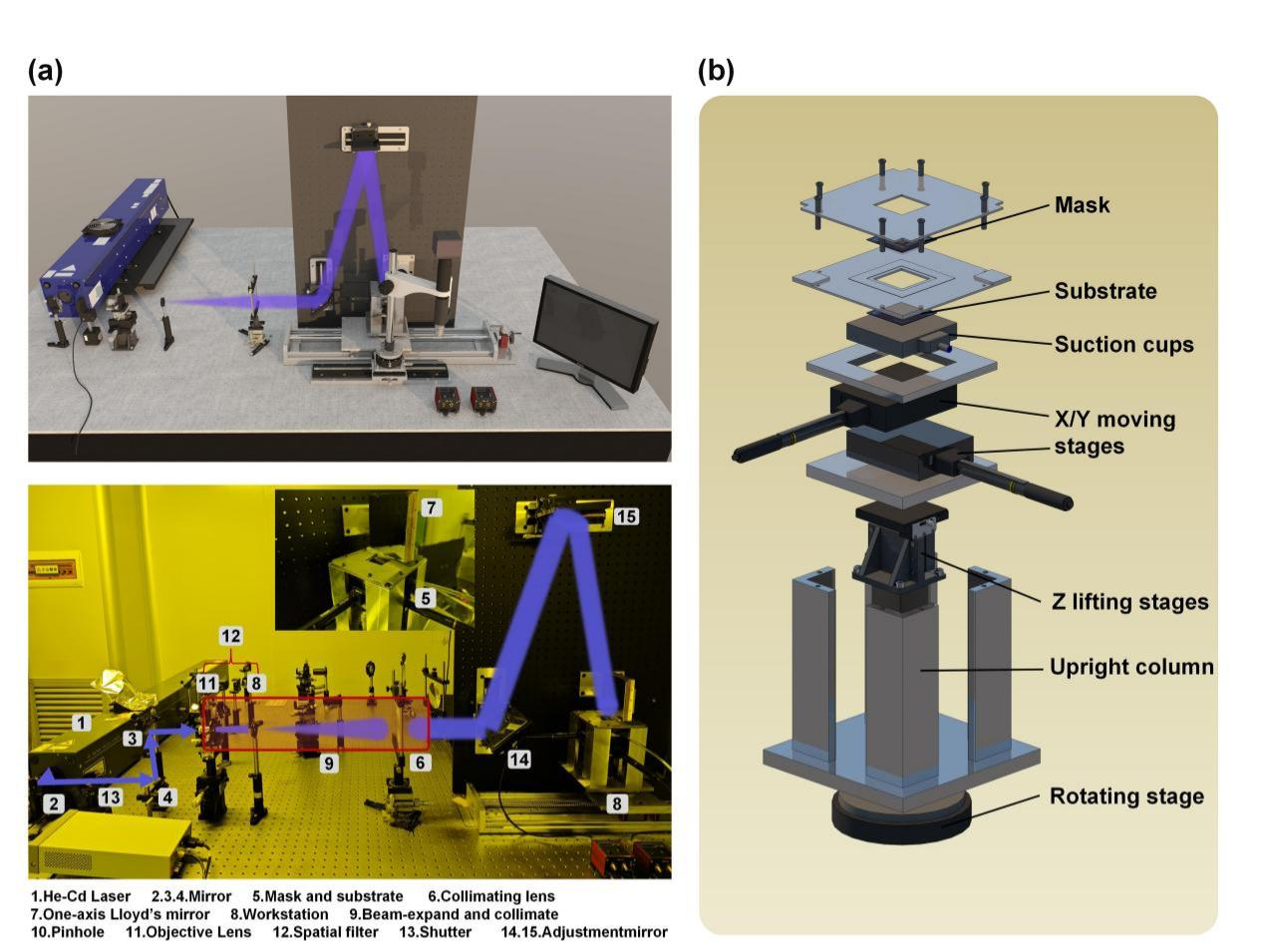
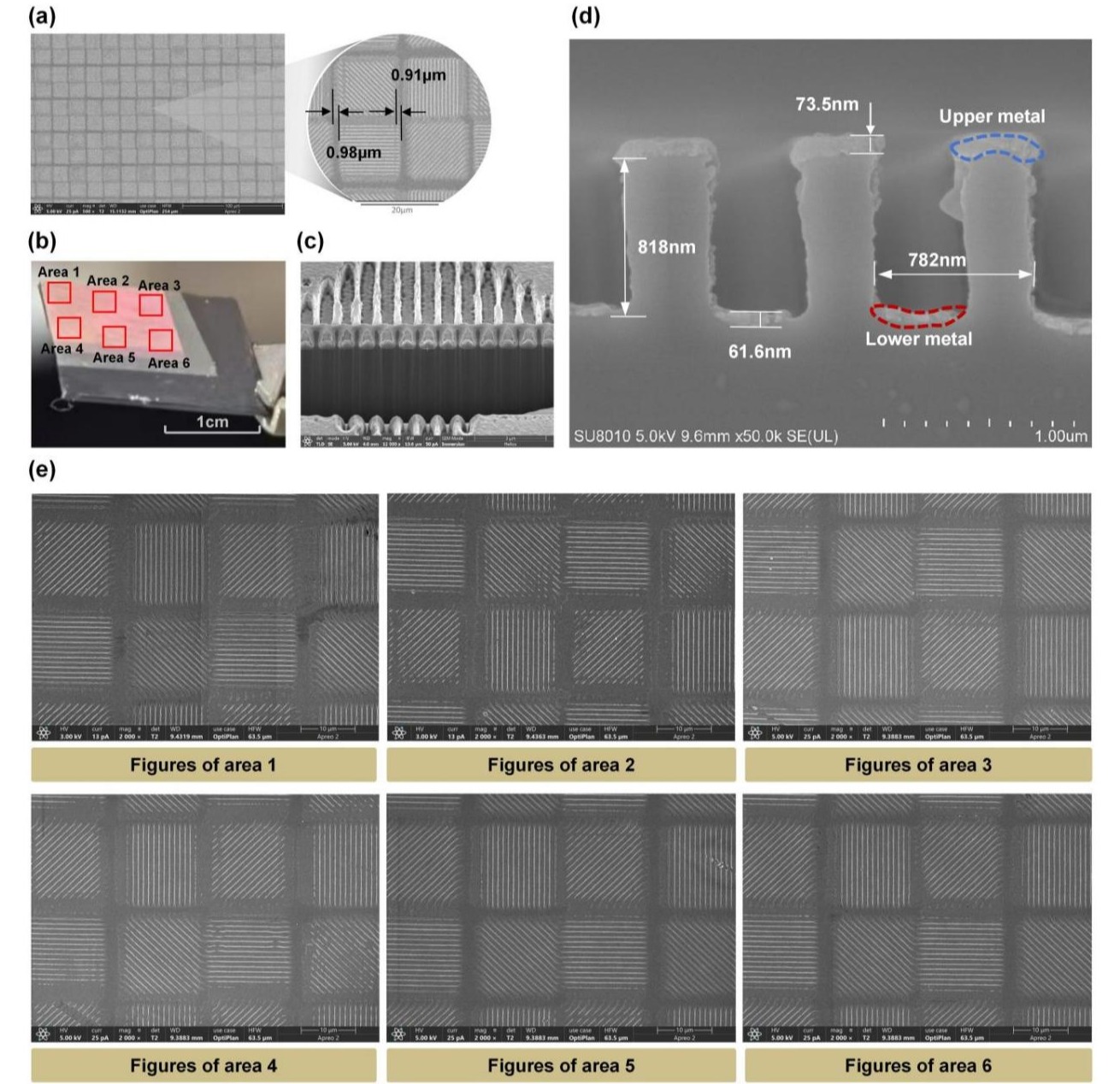
所有評論僅代表網友意見,與本站立場無關。